パワー半導体の開発評価から量産前信頼性試験まで対応
本製品は、高温・高湿・高電圧によるストレス条件下でパワー半導体の絶縁膜経時破壊を評価できます。 高精度な計測と故障時のデバイスへのダメージを最小限に抑える機能により、デバイス開発・信頼性評価における故障解析を支援します。 SiC-MOSFETやIGBTなどのパワー半導体に対し、最大3000Vの高電圧を印加しながら、リーク電流の測定ができます。
Menu
本製品は、高温・高湿・高電圧によるストレス条件下でパワー半導体の絶縁膜経時破壊を評価できます。 高精度な計測と故障時のデバイスへのダメージを最小限に抑える機能により、デバイス開発・信頼性評価における故障解析を支援します。 SiC-MOSFETやIGBTなどのパワー半導体に対し、最大3000Vの高電圧を印加しながら、リーク電流の測定ができます。
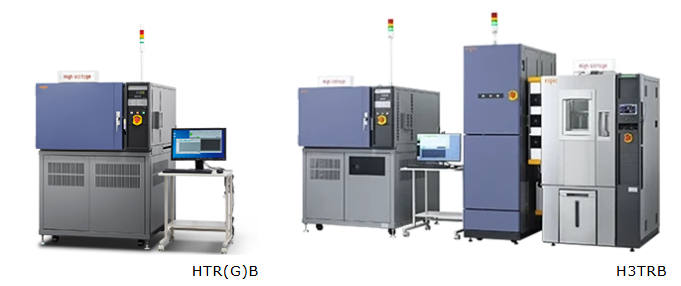
高温逆バイアス試験(HTRB)、高温ゲートバイアス試験(HTGB)、高温高湿逆バイアス試験(H3TRB)の試験を1つのシステムで対応できます。

漏れ電流の測定位置によっては、評価したい漏れ電流を正確に捉えにくいケースがあります。
エスペックの高温逆バイアス試験装置は、デバイス毎の電流計測回路により、ドレイン(コレクタ)端子側とゲート端子側それぞれの電流をデバイスごとに測定できます。
これにより、複数のデバイスを同時に試験しながら、該当デバイスのリーク電流挙動や故障タイミングの把握を支援します。
◆ 配線変更不要のIV特性測定
IV測定としては、Vth測定、On抵抗測定およびブレイクダウン電圧測定の3種類から選択可能です。
試験前、試験中、試験後の任意のタイミングでIV測定を実施でき、経時劣化によるデバイスの特性変化を測定できます。
◆ サンプル損傷を最小限に抑えるためのデバイス保護機能
試験中にデバイスが絶縁破壊する時、電流サージの焼損等により事後解析が困難になるケースがあります。
また、電流サージによって周辺デバイスの試験に影響を及ぼす恐れがあります。
本装置は、デバイスごとにサージ抑制、高速遮断などの保護機能を有し、上記の影響を最小限にします。
