高温下のLSI配線(Cu/次世代材料)寿命劣化試験
LSIの配線信頼性評価で、高温環境下で電流ストレスを印加し、加速条件下で配線寿命を評価するエレクトロマイグレーション(EM)評価試験用装置です。 多数のサンプルの配線抵抗値の変化や断線に至るまでの時間を長時間にわたりモニタリングします。取得データは、寿命予測に必要な各種パラメータの解析に活用することができ、材料開発からプロセス最適化、信頼性保証まで、次世代半導体デバイスの品質向上に貢献します。
Menu
LSIの配線信頼性評価で、高温環境下で電流ストレスを印加し、加速条件下で配線寿命を評価するエレクトロマイグレーション(EM)評価試験用装置です。 多数のサンプルの配線抵抗値の変化や断線に至るまでの時間を長時間にわたりモニタリングします。取得データは、寿命予測に必要な各種パラメータの解析に活用することができ、材料開発からプロセス最適化、信頼性保証まで、次世代半導体デバイスの品質向上に貢献します。
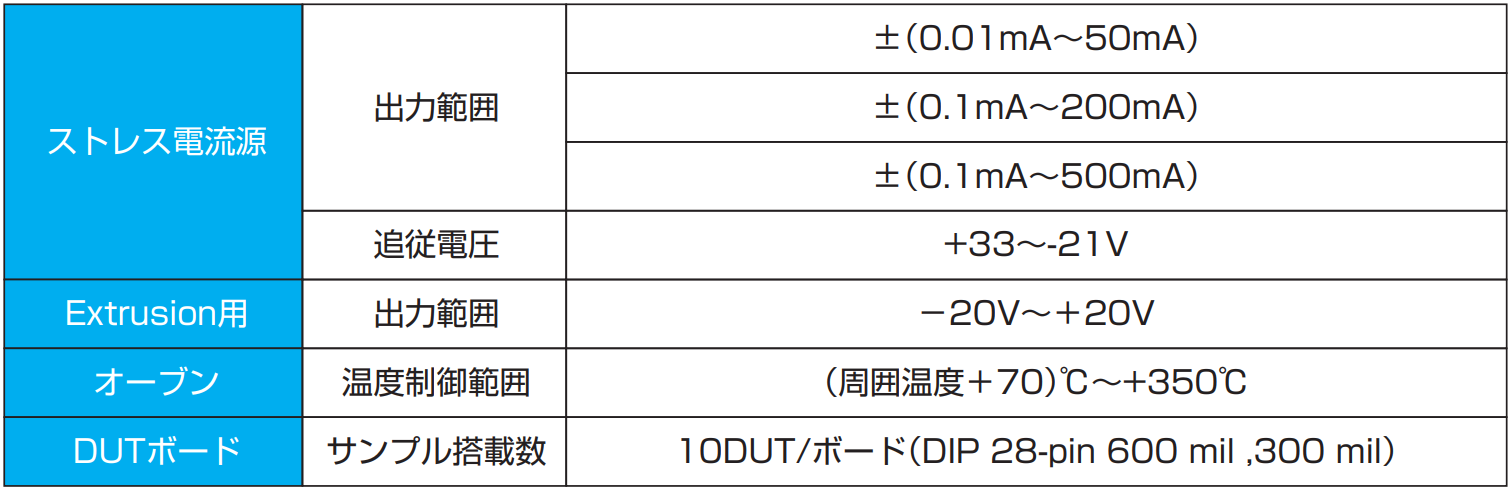

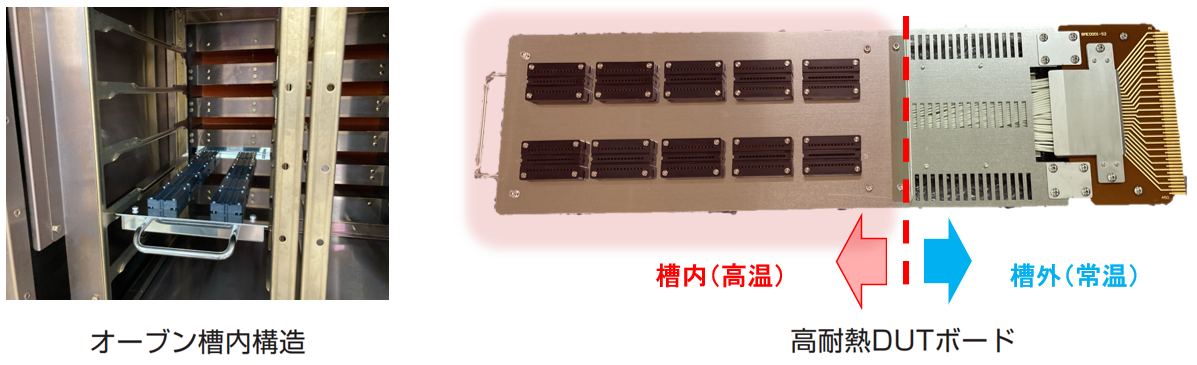
◆ 1台のシステムで最大チャンバー3槽(300ch)を管理
◆ システム電流源は3種類から選択(±50mA仕様、±200mA仕様、±500mA仕様)
◆ 試験は10CH単位ごとに試験条件を設定可能
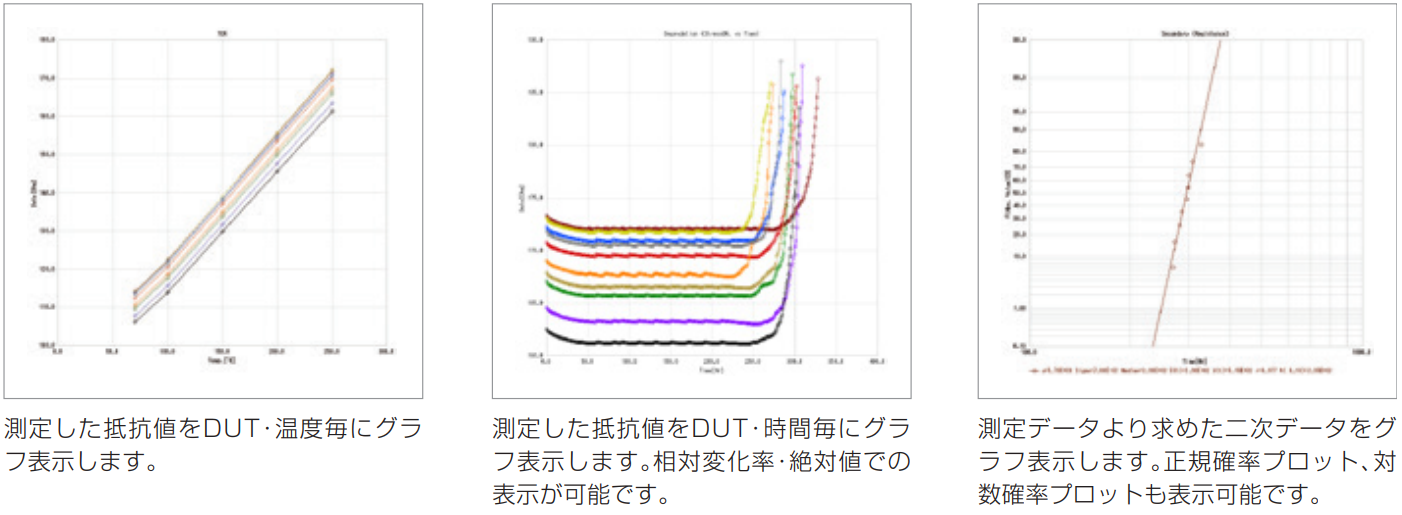
◆ 信頼性試験からデバイス寿命を導くために必要な各種パラメータを自動で算出する解析ソフトを搭載。
◆ 二次データもリアルタイムでグラフを自動更新するため、試験途中でも寿命傾向を視覚的に把握できます。